
Mediciones de difracción de rayos X de alta resolución (HR-XRD) de semiconductores compuestos
2023-09-16 10:00XRD de alta resolución (HR-XRD) es un método común para medir la composición y el espesor de semiconductores compuestos como SiGe, AlGaAs, InGaAs, etc.
Cuando se añaden dopantes o impurezas a uncristal individualred en forma de desplazamiento, la red se deformará debido a la presencia de átomos dopantes. Por ejemplo, en una red de Si, la presencia de átomos de Ge provoca una tensión de compresión porque los átomos de Ge son más grandes que los átomos de Si en la red. Esta tensión cambia el espaciado de la red de Si, y HR-XRD puede detectar esta diferencia de espaciado.

Figura 1: Escaneo teórico HR-XRD de una estructura general bajo tensión de compresión, como una capa de SiGe de 10 nm sobre un sustrato de Si. Los picos a 0 grados provienen de la red de Si en el sustrato.
La presencia de átomos de Ge más grandes hace que los átomos de Si en la capa de SiGe estén más separados, lo que hace que el pico de difracción se desplace a un ángulo más bajo (a la izquierda del pico del sustrato). Debido a que la capa de SiGe de 10 nm es más delgada, el pico de difracción de la capa de SiGe es mucho más ancho que el del sustrato de Si.
En tales películas, sólo se pueden utilizar unas pocas filas de átomos con una determinada disposición para producir una señal de difracción, y ladifracción de rayos XEl pico es más amplio que la difracción de un sustrato de Si, porque hay miles de filas en el sustrato que pueden usarse para producir la secuencia atómica de las señales de difracción. Si la estructura está bajo tensión de tracción, los átomos de Si estarán más espaciados que los átomos de Si en el sustrato, y el pico de difracción correspondiente se moverá a la derecha del pico del sustrato. Los picos adicionales en el espectro, llamados"rayas de espesor,"provienen de una interferencia mejorada de los rayos X reflejados por la interfaz entre la capa de SiGe y el sustrato de Si. Esta es la misma señal que se utiliza para el análisis de reflectancia de rayos X (XRR) y se puede utilizar para determinar el espesor de la capa de deformación.
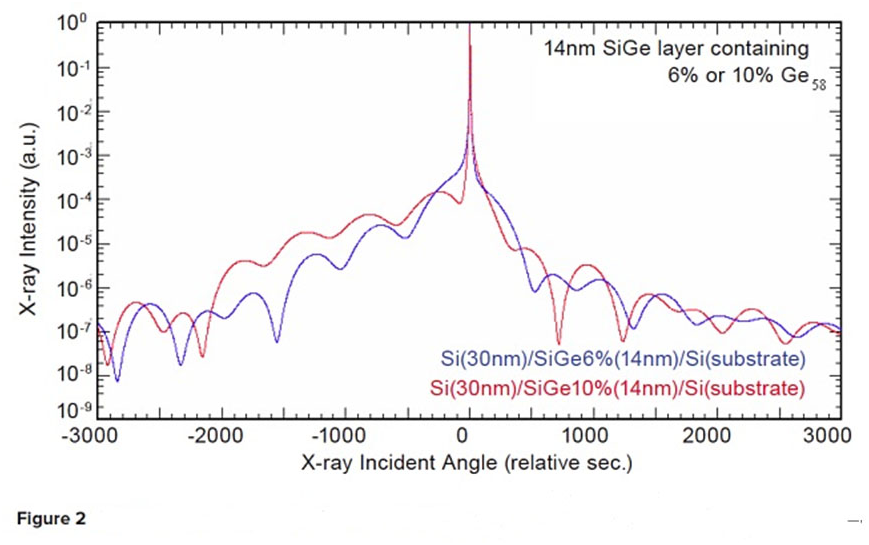
Este método se puede utilizar para determinar la composición de la capa de deformación. La Figura 2 muestra una exploración teórica HR-XRD de dos muestras, cultivadas a partir de Si de 30 nm en SiGe de 14 nm sobre un sustrato de Si. En el primer caso, hay un 6% de Ge en la red, mientras que en el otro caso, hay un 10% de Ge. HR-XRD puede distinguir fácilmente entre estas dos estructuras y determinar el espesor de la capa en función de la franja de espesor.
Además, las técnicas de modelado avanzadas permiten descripciones precisas de características estructurales, como capas de SiGe con estructuras graduadas. HR-XRD puede medir una variedad de materiales epitaxiales, como AlGaAs, InGaAs, InGaN, etc. Generalmente,XRDpuede determinar la composición de estas finas capas de película con una precisión inferior al 1%. Sin embargo, cabe señalar que HR-XRD supone que todos los átomos dopantes están presentes en la red.
